La pulvérisation réactive consiste à pulvériser une cible composée d’un élément que l’on veut déposer dans une atmosphère contenant au moins un gaz réactif. En contrôlant le débit du gaz réactif qui va réagir avec le film en croissance, il est ainsi possible de piloter finement la composition de la couche mince déposée. Cette technique est assez couramment utilisée pour déposer des oxydes (gaz réactif : O2 ou H2O) ou des nitrures (gaz réactif : N2). Cependant, ce gaz réactif peut également réagir avec la cible pulvérisée et en modifier la surface. C’est le phénomène d’empoisonnement de la cible qui engendre une forte modification du fonctionnement du procédé. Ce phénomène peut se visualiser par la présence d’hystérésis sur un certain nombre de paramètres du procédé (Figure ci-dessous).
 Hystérésis présente sur l’intensité émise par O* à 844 nm en fonction du débit d’O2 dans le mélange Ar/O2.
Hystérésis présente sur l’intensité émise par O* à 844 nm en fonction du débit d’O2 dans le mélange Ar/O2.
Pulvérisation réactive à 2 gaz : mélange Ar/O2/N2 pour le dépôt d’oxynitrures
Dans le groupe MATEP, nous avons développé une expertise sur le dépôt de couches minces d’oxynitrures par l’utilisation de la pulvérisation réactive à deux gaz réactifs. Par exemple, des dépôts d’oxynitrures de tantale sont obtenus à partir d’une cible de tantale en mélange de gaz Ar/O2/N2.
(gauche) Principe de la pulvérisation à deux gaz réactifs (droite) cartographie du procédé dans le cas de la pulvérisation de Tantale en mélange Ar/O2/N2 (à débit fixe d’Ar).
Nous sommes capables en suivant différents paramètres du procédé (notamment par spectroscopie d’émission optique) de tracer des cartographies du procédé indiquant le régime du procédé (Régime de pulvérisation élémentaire, transition, régime de pulvérisation de composé oxyde ou nitrure…) selon les débits d’oxygène et d’azote injectés. Ces différents régimes sont ensuite directement reliés au contrôle de la composition élémentaire des oxynitrures. Ces résultats expérimentaux sont également comparés et mieux compris grâce à la modélisation du procédé par un modèle de Berg.
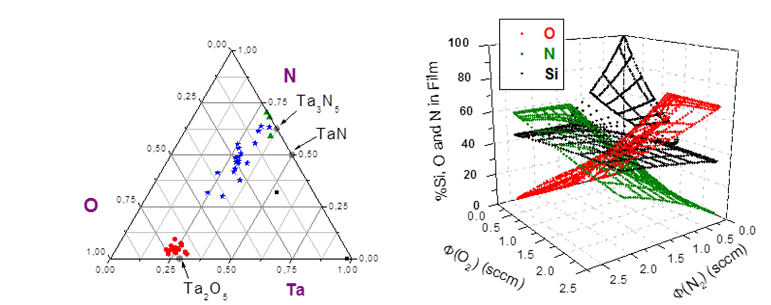 (gauche) Diagramme ternaire des oxynitrures de tantale déposés pour différents mélange Ar/O2/N2,
(gauche) Diagramme ternaire des oxynitrures de tantale déposés pour différents mélange Ar/O2/N2,
(droite) utilisation d’un modèle de Berg pour calculer la composition des films déposés –cas du silicium en mélange Ar/O2/N2.
Publications sur ce sujet :
Control the composition of tantalum oxynitride films by sputtering a Tantalum target in Ar/O2/N2 radiofrequency magnetron plasmas.
A. Bousquet, F. Zoubian, J. Cellier, T. Sauvage, E. Tomasella, Plasma Processes and Polymers 10(11) (2013) 990-998.
Optical Emission Spectroscopy analysis of Ar/N2 plasma in reactive magnetron sputtering
A. Bousquet, L. Spinelle, J. Cellier, E. Tomasella – Plasma Processes and Polymers 6(S1) (2009) p605-609.
Contrôle de la composition des oxynitrures de silicium par l’injection pulsé d’un gaz réactif
Plus récemment, dans le cadre d’une action du LABEX IMOBs3, nous avons travaillé sur le dépôt d’oxynitrure de silicium par pulvérisation en atmosphère à deux gaz réactifs en utilisant la technique d’injection pulsé d’un des gaz réactifs (RGPP = Réactive Gas Pulse Process). A cette occasion, nous avons étudié la cinétique du phénomène d’empoisonnement de cible grâce à des mesures OES résolues en temps, ce qui nous a permis de contrôler la composition des films de SixOyNz à travers les paramètres de pulse appliqués.
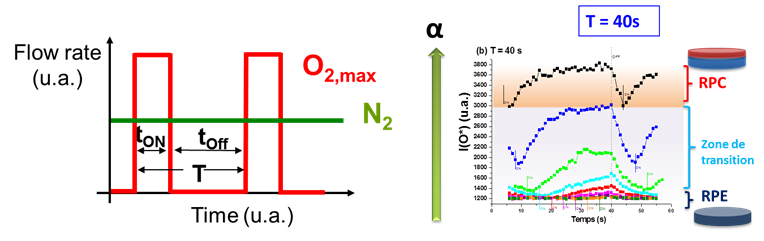
(gauche) Forme de l’injection pulsé d’O2, (droite) Mesures OES résolues en temps durant les pulses d’injection de O2.
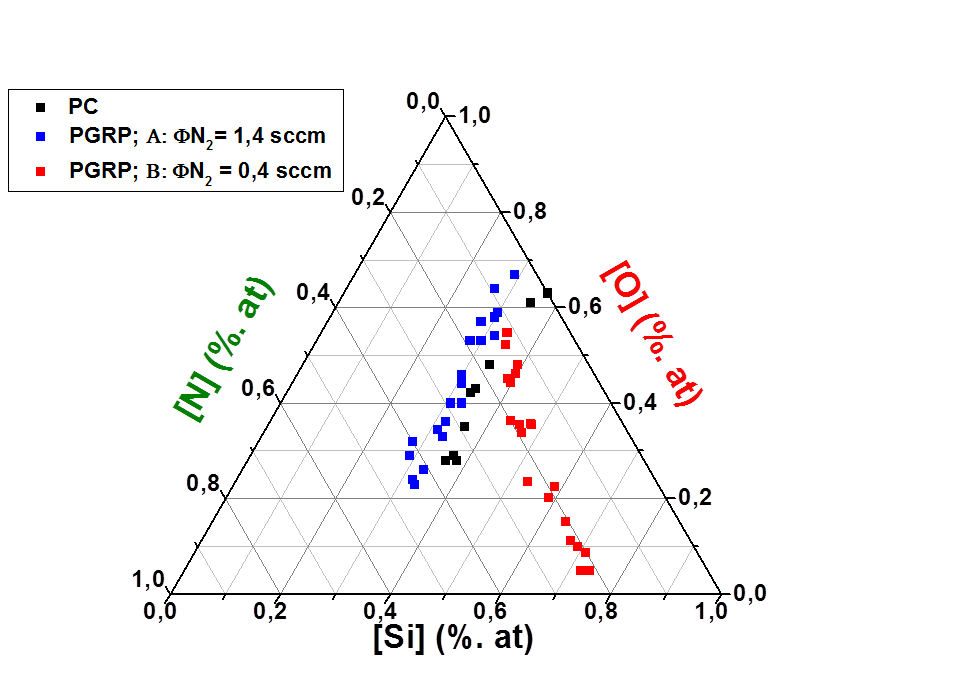 Composition des oxynitrures obtenus selon le débit fixe de N2 et les paramètres de pulse utilisé pour contrôler le débit de O2.
Composition des oxynitrures obtenus selon le débit fixe de N2 et les paramètres de pulse utilisé pour contrôler le débit de O2.
Publications sur ce sujet :
Reactive Gas Pulsing Sputtering Process, a promising technique to elaborate silicon oxynitride multilayer nanometric antireflective coatings
A Farhaoui, A Bousquet, R Smaali, E Centeno J Cellier, C Bernard, R Rapegno, F Réveret and E Tomasella – J Phys D : Appl Phys – 50 (2017) 015306.
Contrôle in-situ d’un procédé hybride : PVD/évaporation pour le dépôt de CIGS
Dans le cadre d’une collaboration avec l’IRDEP (Institut de Recherche et Développement en Energie Photovoltaïque), nous avons étudié leur nouveau procédé de dépôt hybride associant co-pulvérisation de cibles métalliques et évaporation du sélénium pour le dépôt de CIGS comme absorbeur de cellule photovoltaïque. Pour une conversion optimale de la lumière, cette couche de CIGS doit avoir une composition très précise. Le challenge était de contrôler cette composition avec ce nouveau procédé. Grâce à des mesures OES, nous avons pu relier la composition des films déposés, et par exemple leur rapport Cu/(In+Ga), à des informations contenues dans la phase plasma. D’autre part, nous avons étudié l’empoisonnement des cibles lors de l’évaporation du sélénium pour ainsi en maîtriser l’incorporation dans les films.
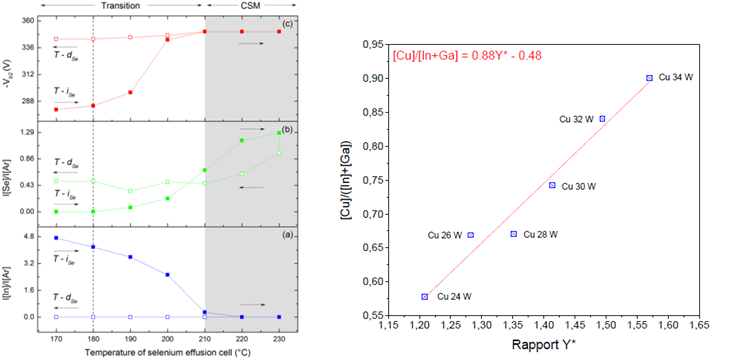
(gauche) Lien entre le rapport de composition des films Cu/(In+Ga) avec le rapport d’intensité des espèces mesuré par OES (droite) étude de l’empoisonnement d’une cible d’indium par l’effusion du sélénium.
Publications sur ce sujet :
Investigations of temperature and power effects on Cu(In,Ga)Se2 thin film formation during a three-stage hybrid co-sputtering/evaporation process.
J. Posada, M. Jubault, A. Bousquet, E. Tomasella, D. Lincot – Progress in Photovoltaics : Research and Applications. (DOI:10.1002/pip.2926) - 2017.
In Situ Monitoring of Cu(In1-x,Gax)Se2 Composition and Target Poisoning by Real Time Optical Emission Spectroscopy During Deposition From a Hybrid Sputtering/Evaporation Process.
J. Posada, A. Bousquet, M. Jubault, D. Lincot, E. Tomasella – Plasma Processes and Polymers – 13 (2016) 997-1007.
In-situ optical emission spectroscopy for a better control of hybrid sputtering/evaporation process for the deposition of Cu(In,Ga)Se2 layers.
J. Posada, M. Jubault, A. Bousquet, E. Tomasella, Daniel Lincot – Thin Solid Films, 582 (2015) 279-283.
Sources micro-ondes additionnelles pour un procédé PVD/PECVD – dépôt de SiCxNy:H
Dans le cadre d’un projet ANR HD PLASMA en collaboration avec PROMES (Perpignan), l’IMN (Nantes) et l’IJL (Nancy), nous étudions un procédé hybride PVD/PECVD dans lequel 4 sources micro-ondes sont associées à la pulvérisation radiofréquence d’une cible. L’objectif est de déposer des carbonitrures de silicium hydrogénés de composition ajustable, comme couche antireflet et de passivation pour les cellules solaires de première génération. Pour cela, nous travaillons sur la pulvérisation d’une cible de silicium dans une atmosphère Ar/N2/CH4. Les sources micro-ondes à mi-distance entre la cible et le substrat permettent d’une part d’augmenter le flux d’ion pulvérisant la cible et d’autre part de contrôler la dissociation du méthane indépendamment de la pulvérisation de la cible.
Publications sur ce sujet:
“SiCN:H thin films deposited by MW-PECVD with liquid organosilicon precursor: gas ratio influence vs properties of the deposits” B. Plujat, H. Glénat, A. Bousquet, L. Frézet, J. Hamon, A. Goullet, E. Tomasella, E. Hernandez, S. Quoizola, L. Thomas, Plasma Processes and Polymers, (doi.org/10.1002/ppap.201900138).
“Composition and optical properties tunability of hydrogenated silicon carbonitride thin films deposited by reactive magnetron sputtering” A. Bachar, A. Bousquet, H. Mehdi, G. Monier, C. Robert-Goumet, L. Thomas, M. Belmahi, A. Goullet, T. Sauvage, E. Tomasella, Applied Surface Science, 444 (2018) 293-302.